Module Design Considerations:
Module Packaging Comparison
| Advanced | Traditional | ||||
|---|---|---|---|---|---|
| Baseless Packaging Technology | Copper Baseplate | Alsic Baseplate | Aluminum Baseplate | IMS Technology (AL) | |
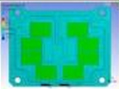 |
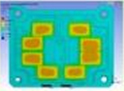 |
 |
 |
 |
|
| Thermal resistance index | 0.4 | 1.0 | 1.1 | 1.2 | 1.4 |
| Max usable temperature | 200°C | 150°C | 150°C | 150°C | 150°C |
| Fatigue resistance | superior | fair | good | poor | excellent |
| Flatness (per inch) | <=0.003 | >=0.005 | N/A | >=0.005 | >=0.005 |
| Cost factor | $ | $$$$ | $$$$$ | $$$ | $$ |
| Weight index | 0.2 | 1.0 | 0.5 | 0.5 | 0.5 |
| Typical package height (for a comparable module) | 0.2 inch | 0.325 inch | 0.37 inch | 0.325 inch | 0.325 inch |
Power Packaging & Cooling
SMD-0.2,0.5 High Strength Packages:
